 |
 |
 |
| Главная Журналы Популярное Audi - почему их так назвали? Как появилась марка Bmw? Откуда появился Lexus? Достижения и устремления Mercedes-Benz Первые модели Chevrolet Электромобиль Nissan Leaf |
Главная » Журналы » Моделирование СВЧ транзисторов 1 2 3 4 ... 6 моделирование свч транзисторов В основе механизма работы СВЧ транзисторов и транзисторов более низких частот лежат одни и те же законы. Поэтому книгу, посвященную применению СВЧ транзисторов, можно было бы начать с рассмотрения специфических особенностей транзисторов на СВЧ, предположив, что их общая теория хорошо знакома большинству читателей. Однако из-за специфики диапазона разработчиками СВЧ усилителей, которым адресована книга, чаще становятся не разработчики низкочастотной транзисторной аппаратуры, а специалисты СВЧ. Последние же обычно недостаточно хорошо знакомы с теорией транзисторов. Поэтому в настоящем параграфе автор сконцентрировал тот минимум сведений о работе транзистора, который, по его мнению, необходим для дальнейшего чтения. Подробное изложение теории транзисторов приведено в [1.2-1.6]. Биполярный плоскостной транзистор состоит из двух последовательно включенных р - -переходов, промежуток W между которыми столь мал, что рекомбинация носителей в пространстве между переходами незначительна. Так, в р - п - р-транзисторе внешние области полупроводника с дырочной проводимостью (основными носителями являются дырки) образуют эмиттер и коллектор, а между ними расположена область с электронной проводимостью. В и -р -п-транзисторе основными носителями в эмиттере и коллекторе являются электроны, а в базе -дырки. 6 На рис. 1.1,а, б схематически изображены р - п - р-транзистор, который для определенности будем рассматривать в рабочем режиме, и его потенциальная диаграмма (точки =\{х), где - энергия электрона). Поскольку концентрация дырок в эмиттере такого транзистора намного больше, чем в базе, а концентрация электронов в базе намного больше, чем в эмиттере, дырки из эмиттера диффундируют в -область базы, а электроны- в р-область эмиттера. При этом в базе образуете? положительный заряд дырок и ионизованных доноров, а в эмиттере отрицательный заряд электронов и ионизированных акцепторов (рис. 1.2). В отличие от концентрации доноров Л^д и акцепторов JVa, концентрация свободных зарядов изменяется не скачком, а в областях с противоположным типом проводимости плавно спадает от PpNa до р„= 2,-/ и от Ппл до Пр=п\1рр. (Здесь и далее буквами р, п, обозначены концентрации дырок и электронов в полупроводнике с соответствующим типом проводимости, полупроводники с дырочной, электронной и собственной проводимостью обозначены индексами р, , i). При этом на границе раздела проводимостей образуется слой полупроводника, обедненный носителями обоих знаков. В отсутствие внешнего напряжения из-за диффузии дырок и электронов возникает разность потенциалов между областями с разной проводимостью, что вызывает встречный дрейф носителей. При этом устанавливается динамическое равновесие, т. е. диффузионные и дрейфовые 7 г  Рис. 1.1  компоненты носителей каждого знака становятся равными, и суммарный ток через р - -переход равен нулю. В отсутствие внешнего напряжения аналогично поведение и перехода база - коллектор. При приложении к переходу эмиттер - база напряжения и в прямом направлении потенциальный барьер 1]5 снижается, в результате плотность тока диффузии дырок jpfii=-qDdNIdx из эмиттера в базу возрастает при практически неизменном встречном дрейфе: /др=0/г&др. Здесь q, D,v - заряд, коэффициент диффузии и скорость дрейфа носителей; N - концентрация ионизованных примесей. В действительности диффузионные потоки увеличиваются в обоих направлениях, т. е. увеличивается и поток электронов из базы в эмиттер. Поскольку в р - п - р-транзисторе полезным является диффузионный ток дырок, создающий коллекторный ток, а встречный диффузионный ток электронов, замыкающийся через вывод базы, - бесполезным, качество эмиттерного перехода удобно характеризовать отношением диффузионного тока дырок /р в область базы к суммарному току эмиттера Ip-{-In=h, называемым эффективностью эмиттера уо- Это отношение равно отношению концентраций основных носителей в эмиттере и базе. Если концентрация дырок в р-области намного больше концентрации электронов в -области, потоком электронов из области базы в эмиттер можно пренебречь и учитывать только инжекцию дырок в область базы. Под инжекцией понимают впрыскивание носителей через барьер, сниженный внешним напряжением, в область, где они являются неосновными. При инжекции у границы перехода в базе создается избыточная концентрация дырок р'(0) =р„е-9/, превышающая равновесную концентрацию дырок в этой области (рп) и спадающая внутри полупроводника по экспоненциальному закону (при малом уровне инжекции р'(0)<Срп). Из-за значительного градиента концентрации дырок они диффундируют в направлении коллектора. Объем- Рис. 1.2 ный заряд дЫроК создает электрическое поле, перераспределяющее в течение максвелловского времени релаксации, т. е. практически мгновенно, электроны в базе*>, заряд которых компенсирует положительный заряд дырок. Ввиду этого область базы останется в целом близкой к нейтральной, а неосновные носители - дырки будут диффундировать как незаряженные частицы. В стационарном режиме при отсутствии рекомбинации и Yo=l количество дырок, входящих в базу через эмиттерный переход и выходящих из нее через коллекторный, будет одинаковым и управление транзистором будет осуществляться без потребления тока от источника напряжения смещения эмиттер - база. При равномерном распределении примесей в базе поле в ней отсутствует и дырки распространяются только диффузией, при неравномерном же - и дрейфом. Так, при экспоненциальном распределении примесей электроны, сместившиеся из-за градиента концентрации примесей, и неподвижные связанные с кристаллической решеткой ионизованные доноры создадут электрическое поле, которое ускорит движение дырок по направлению к коллектору. Если полупроводник коллектора заменить металлом, т. е. коллекторный р - /г-переход невьшрямляющим электродом, то полученная структура будет соответствовать полупроводниковому диоду. Ток во внешней цепи, поддерживаемый сторонней э. д. с, будет осуществляться электронами - единственными носителями тока в металле. Однако проводимость в транзисторе обусловлена носителями обоих знаков, именно поэтому рассматриваемые приборы называют биполярными. Аналогично можно описать и переход база - коллектор, если рассматривать его вне связи с эмиттерным переходом, т. е. заменить последний невьшрямляющим контактом и подать на него напряжение в прямом направлении. Однако коллекторный р -/г-переход смещен в обратном направлении. Высота потенциального барьера этого перехода увеличена, а диффузионные составляющие тока малы. При достаточно большом обратном смещении через р - /г-переход протекают лишь дрейфовые составляющие тока. * Недостающее количество электронов в момент включения поступает от источника. функционирование транзистора обусловлено взаимодействием двух р - -переходов. Поле коллекторного р - -перехода направлено так, что оно затягивает неосновные носители в области базы (дырки) в коллектор. При этом их концентрация в базе на границе коллекторного перехода становится меньше равновесной, а установившийся градиент концентрации и является причиной диффузии дырок в базе. I I Рис. 1.3 Выведению дырок из базы в коллектор с помощью электрического поля внешнего источника - экстракции дырок - сопутствует дрейф электронов из коллектора в область базы. В проводнике носителями заряда являются электроны, которые при подключении внешнего источника, соединенного с коллектором, компенсируют дырки, экстрагированные из базы, а также осуществля- ; ют электронный ток через коллекторный переход. В заключение рассмотрим, из каких составляющих слагается ток во внешней цепи базы. Мы уже упоминали об этих составляющих. Это ток встречной диффузии электронов из базы в эмиттер и ток электронов, вызванный рекомбинацией дырок, пересекающих базу. Третья составляющая, обратная по направлению первым двум, представляет собой обратный ток коллекторного перехода. Электронные токи, обусловленные этими факторами, показаны на рис. 1.1 стрелками 1-3 соответственно. Чтобы объяснить, как в биполярном транзисторе происходит усиление, включим в цепь эмиттера источник сигнала, а в цепь коллектора выходную нагрузку (рис. 1.3,а). Тогда инжекция дырок в базу в каждый момент времени будет пропорциональна напряжению эмиттер - база, промодулироваиному входным сигналом. Сопротивление эмиттерного перехода входному сигналу (например, синусоидальному) намного меньше сопротивления коллекторного перехода, включенного в запирающем направлении. Это позволяет, включив в цепь коллектора достаточно высокое сопротивление нагрузки, выделить на нем мощность, большую мощности, отдаваемой источником входного сигнала. При высокой эффективнести эмиттера (уо1), малой рекомбинации в базе и малом значении обратного тока через коллекторный переход или при взаимной компенсации этих токов коллекторный ток приблизительно равен эмиттерному. В этом случае энергетический выигрыш достигается за счет упоминавшейся разницы во входном и выходном сопротивлениях транзистора, который преобразует энергию постоянного источника в энергию на частоте сигнала *>. На достаточно низкой частоте емкостными эффектами и пролетными временами можно пренебречь и полагать, что фазы входного и выходного напряжений совпадают аналогично тому, как это происходит в электронной лампе, включенной по схеме с общей сеткой. Полупроводниковым аналогом последней является транзистор, включенный по схеме с общей базой (ОБ). Это означает, что источник сигнала и нагрузка имеют общую по высокой частоте точку с выводом базы (рис. 1.3,а). Аналогично работает усилитель, когда источник сигнала включен в базовый электрод, а зажим эмиттера является общим для источника сигнала и нагрузки (схема с общим эмиттером на рис. 1.3,6). В таком включении, однако, усиление по мощности будет обусловлено и усилением по току, поскольку ток, отбираемый от источника сигнала при том же напряжении на эмиттерном переходе, что и в схеме с ОБ, будет намного меньше, чем в последней; как упоминалось, при 0=1 он равен разности рекомбинационной составляющей и обратного тока коллекторного перехода. Рассмотрим (пока также качественно), что будет происходить в транзисторе с увеличением частоты уси- * Напомним, что генератор с действительным внутренним сопротивлением отдает наибольшую мощность во внешнюю цепь при равенстве его внутреннего сопротивления сопротивлению нагрузки. И ливаемого сигнала. Известно, что с увеличением частоты эффективность транзистора уменьшается. Это связано с конечным временем пролета / носителей от эмиттера к коллектору. При этом уменьшается амплитуда выходного сигнала и искажается /fix А Рис. 1.4 его форма. Из-за различия скоростей теплового движения носителей в процессе их - диффузии в базе пакет носителей, сформированный входным модулирующим сигналом, размывается во времени и тем в большей сте- - пени, чем больше время пролета носителей. Пока время запаздывания мало по сравнению с периодом колебания или длительностью одиноч- - ного импульса, указанное размытие несущественно; с увеличением времени запаздывания сигнал все более искажается и уменьшается его амплитуда (рис. 1.4), и это, в конечном счете, ограничивает возможное увеличение частоты. С увеличением частоты фазовая задержка будет увеличиваться из-за запаздывания носителей не только в базе, но и в коллекторе. Соизмеримость времени задержки в коллекторе и базе является характерной особенностью СВЧ транзисторов. Еще одной причиной существенного увеличения запаздывания является соизмеримость с периодом колебания времени, требуемого для заряда емкостей эмиттера и коллектора. Наконец, важнейшим фактором, ограничивающим частотный предел СВЧ транзисторов, является, как мы убедимся в дальнейшем, сопротивление базы. 1.2. МОДЕЛИ СВЧ ТРАНЗИСТОРОВ СВЧ транзисторы - приборы планарно-эпитакси-ального типа, имеющие многоэмиттерную *) встречно-штыревую структуру с чередующимися областями эмит- *) Далее для простоты рассматривается модель транзистора с одним эмиттером. тера и базы и эмиттерные н базовые контакты на внешней поверхности кристалла (рис. 1.5). Принципиальные частотные ограничения связаны, как уже упоминалось, с движением носителей в продольном (вдоль оси г) направлении, для их отражения достаточно использовать одномерную модель и можно пренебречь поперечными эффектами. Антивная Ваза Пассивная Basa \Эмиттер (р) э I б Эпитансивльныи f слой~2мнп 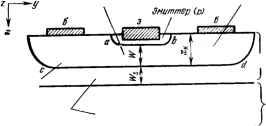 EffiaW) Кдллетор (р) Тело коллектора Рис. 1.5 Ограничения, вызванные структурой транзистора в поперечном (вдоль оси у) направлении, обычно относят к технологическим (их не отражают в теоретической модели транзистора), тем не менее они имеют принципиальный характер. Эти ограничения связаны с тем, что расстояние между эмиттерным и базовыми контактами не может быть сделано пренебрежимо малым и между областью эмиттерного перехода и базовым контактом находится область пассивной базы, имеющая конечное сопротивление для источника входного СВЧ сигнала и ухудшающая свойства транзистора с увеличением частоты. Принципиальность этого ограничения объясняется, в частности, тем, что уменьшение времени пролета носителей через базовую область путем ее уменьшения в продольном направлении обычно приводит к увеличению ее сопротивления в поперечном направлении. Одним из способов сглаживания этого противоречия является уменьшение ширины активной базы (1) при сохранении пассивной (Хк) и создание разной концентрации примесей в этих областях. Моделируя СВЧ транзистор, целесообразно изобразить его двухмерную графическую модель и затем ото- бразить каждую ее область соответствующей электриче- ской моделью. Такая графическая модель СВЧ р~п-р-транзистора приведена на рис. 1.5. Линии аЬ и cd представляют соответственно эмиттерный и коллекторный переходы, заштрихованные области-невыпрямляющие эмиттерный, базовый и коллекторный контакты, области протяженностью W под эмиттером и Wj,Ws в коллекторе- активную базу и обедненную область в эпита-ксиальном слое коллектора, базовая область протяженностью Хк - пассивную базу. Масштаб на рисунке не соблюден. Рассмотрение технологии здесь не является самоцелью, она затрагивается лишь в той степени, в которой помогает выявить структуру и построить модель СВЧ транзистора. Так, в эпитаксиальном транзисторе диффузия осуществляется не в исходную пластину (тип ее проводимости определяет проводимость коллекторной области), а в предварительно наращенный на нее методом эпитаксии тонкий слой полупроводника того же типа. Этот слой характеризуется высокой концентрацией примесей, необходимой для уменьшения длины обедненной области коллектора. На рис. 1.5 показаны тонкий эпитаксиальный слой протяженностью x-j-Ws и тело исходной пластины коллектора с низкой концентрацией примесей. Для создания нужной структуры на поверхность эпи-таксиального слоя наносят защитную диэлектрическую пленку, затем с помощью фотолитографии создают на ней рисунок и через окна в этом рисунке в полупроводник с помощью диффузии вводят нужные примеси. Знак проводимости легирующей базу примеси для создания коллекторного перехода должен быть обратным знаку проводимости исходной пластины, для создания эмиттерного перехода тот же знак, что и у проводимости исходной пластины; при этом концентрация примеси должна быть столь велика, чтобы в области эмиттера осуществить инверсию знака проводимости. На рис. 1.5 окна для введения примесей обозначены cd и аЬ для коллекторного и эмиттерного переходов соответственно. Металлизированные дорожки в области эмиттера и базы и металлизированная внешняя сторона тела коллектора служат контактами с соответствующими областями. Теперь перейдем к электрическому моделированию транзистора. Как следует из § 1.1, перенос носителей в транзисторах обусловлен как электрическими, так и молекулярными силами. Для анализа радиотехнических устройств достаточна модель на электрическом уровне , в частности для линейных малосигнальных устройств СВЧ модель, сводящаяся к iLC-эквивалентной схеме с сосредоточенными элементами и управляемыми генераторами. Соответственно все дальнейшее рассмотрение проводится в линейном малосигнальном приближении, согласно которому амплитуда сигнала столь мала, что она не может изменить режим транзистора по постоянному току и параметры его эквивалентной схемы. Критерием справедливости этого приближения является неизменность коэффициента усиления транзистора при изменении амплитуды входного сигнала. Нелинейные режимы работы транзистора, характеризуемые уменьшением усиления и возникновением гармонических составляющих, в этой книге не рассматриваются. Моделирование продольной структуры СВЧ транзистора. Количественное рассмотрение процесса распространения сигнала от эмиттера к коллектору позволяет построить модели элементов продольной структуры СВЧ транзистора. Эмиттерный переход. Малосигнальная модель эмиттерного перехода состоит из дифференциального сопротивления перехода Ra и его зарядной емкости Сд. Сопротивление Яэ определяется наклоном вольт-амперной характеристики (рис. 1.6) (1.1) Здесь /диф, /др, / - диффузионная и дрейфовая составляющие и ток насыщения эмиттерного перехода, равный его обратному току; t/ -внешнее напряжение на переходе; <7=1,6-10-в /г=1,38-10-23 Дж/град, 7=300 К-заряд электрона, постоянная Больцмана и абсолютная температура соответственно. Соотношение между током, протекающим через переход, и его сопротивлением может быть получено дифференцированием выражения (1.1) /?,[0м] = /э[мА] (1.2) Зарядная емкость Сэ (рис. 1.7) образуется слоем противоположных по знаку неподвижны;< зарядов по обе стороны перехода. При приложении к переходу внешнего напряжения U в обратном непроводящем направлении разность потенциалов на нем увеличивается до У=г1з„---\-U, в результате чего увеличивается протяженность слоя Wa ионизированных примесей зарядов. Последнее может быть истолковано как уменьшение емкости Сэ образующегося конденсатора.
Рис. 1.6 Рис. 1.7 Зарядную емкость эмиттерного перехода обычно аы-числяют в приближении резкого р - /г-перехода, протяженность объемного заряда которого в области базы намного больше, чем в области эмиттера из-за Na>N, Протяженность заряда в области базы Гз=(21/е/9Л^ )/2 (1.3) вычисляют в этом случае, интегрируя уравнение Пуассона d4 j-=--а, зарядную емкость как С = , где Q = = f Njdx. При этом получают о Сэ=Лэ(е9Л^ б/(21/))>2 (1.4) где е=еоеотн - диэлектрическая постоянная; ео=8,88Х Х10-2 ф/м, еотн=16 для Ge; l/=i]j-ft/ -алгебраическая сумма контактной разности потенциалов я)? (0,724 для Ge, 1,18 для Si) и внешнего напряжения U (здесь t/>0 для обратных смещений); Л/дб - концентрация доноров в базе вблизи эмиттера; Лэ -площадь эмиттера. В транзисторе профиль концентраций определяется диффузией примесей двух разных знаков и переход является резким лишь в области эмиттера. Поэтому для вычисления зарядной емкости иногда пользуются соотношением для плавного р - /г-перехода. Точные значения емкости для этого случая получаются численными методами. Приближенные значения получены в работе [1.7]. Емкостная составляющая эмиттерного тока представляет собой изменение во времени вектора электрического смещения. С увеличением частоты эта составляющая увеличивается, шунтируя входной сигнал в цепи управления транзисторов. Ток /г, характеризующий инжекцию, связан с общим током через переход h соотношением = 1 + ]шСз/?з +с!С'з/?з - где <p=arctg (оСэ- На частоте (й=(йэ=1 ?эСэ модуль тока h уменьшается по сравнению с низкочастотным (НЧ) значением в Y2 раз, а фазовый сдвиг фэ=45°: (1.6) Временная задержка сигнала на частоте Юэ составит /э=Фэ/соэ=я/(4(Оэ). (1.7) При (оСэ^?э<с1 значение тангенса в выражении для ф можно заменить углом ф=мСэ/?о и тогда время задерж ки не зависит от частоты: 4=ф/(й==/?эСэ. (1.8) Поскольку /э=/8 вх - входной ток эмиттерной цепи, /г= =/эвых - выходной, а НЧ значение эффективности эмиттера уо=1г11а<1, то ВЧ значение коэффициента передачи эмиттера э вых . Yo Y = где 1+]й>/<0з (1.9) pэ Диффузионной емкостью эмиттера Сд ф: ражающеи ток его внешней 2-384 [Т|И РПРРТЯНЯРПНВ! БИБЛИОТЕЧЛ X и Р э рщей 17 нейтральность базы (нарушаемую модуляцией переменной составляющей тока подвижных носителей), в малосигнальной эквивалентной схеме малошумящих СВЧ транзисторов обычно пренебрегают* [1.13]. База. При отсутствии электрического поля движение носителей в базе осуществляется посредством диффузии. Плотность тока при этом пропорциональна коэффициенту диффузии Dp и градиенту концентрации dP/dx: j=-qDpdPldx. (1.10) Решение уравнения диффузии для переменной составляющей определяет в этом случае задержку сигнала /g обусловленную переносом носителей через базу, и коэффициент переноса базы, равный отношению токов, входящих в базу и выходящих из нее, P*=Schj5- + jco. (1.11) где W - толщина базы; L - диффузионная длина неосновных носителей в базе, т. е. расстояние, на которое они сместятся £за время их жизни; D=\Dp{0)Dp(W) - эффективный коэффициент диффузии дырок в /г-базе, определяемый коэффициентами диффузии дырок в плоскостях, прилежащих к эмиттеру Dp(0) и коллектору Dp(ir). На относительно низкой частоте и при малой рекомбинации в объеме {WIL<1) НЧ коэффициент переноса может быть принят равным единице: ro=schW/Ll. (1.12) Коэффициент переноса базы р* иногда называют коэффициентом передачи теоретической модели отм, а соответствующую критическую частоту обозначают т^. С другой стороны, на относительно низких частотах р* является внутренним коэффициентом передачи тока транзистора т. е. коэффициентом передачи, которым обладал бы транзистор в режиме с ОБ при коротком замыкании на выходе и сопротивлении базы, равном нулю. В СВЧ *) При учете С„иф управляющим током генератора, моделирующего перенос носителей через базу, является суммарный ток, протекающий через Rb и С„иф, соединенные параллельно, а эффективность эмиттера по-прежиему учитывается (1.9). Транзисторах р* не является ни коэффициентом передачи теоретической модели, ни внутренним коэффициентом передачи (см. (1.28)). Мы будем пользоваться правильным обозначением для коэффициента переноса базы Р*, сохранив вследствие исторически сложившейся терминологии неправильное обозначение ш для ее частоты (О, На частоте CU=:lD =10=2,43D/U7 (1.13) коэффициент переноса р* =. sch p/ j2,43 = (1 /УТ) е~°. т. е. его модуль уменьшается до 1/V2 НЧ значения, а фазовый сдвиг составляет 1 рад. Время задержки на этой частоте (1.14) е*~о)р,со -2,43D Частотные характеристики р* становятся наглядными после введения в (1.11) критической частоты базы p*=schi/ ja)2,43/cu (1.15) и представления (1.15) в виде графика на рис. 1.8. Заметим, что /g, не равно среднему времени пролета носителей через базу, а последнее не равно времени пролета to=WID, вычисленному в предположении свободной диффузии с постоянной скоростью. Можно показать [1.2], что U=tol2=Wy{2D). Соотношения (1.10) -(1.15) справедливы для диффузии носителей при отсутствии электрического поля в базе, например при равномерном распределении примесей в сплавных транзисторах. При наличии ускоряющего поля в базе, например, СВЧ транзисторов, изготовленных методом диффузии, концентрация примесей в базе у эмиттерного перехода Л^б(О) больше, чем у коллекторного NiW). В результате поле в базе зависит от координаты X, а перенос носителей обусловлен как диффузией, так и дрейфом. Последнее должно быть учтено в правой части уравнения (1.10) членом qpv=qyippE, где \ир - подвижность дырок, а Е - напряженность поля. Решение уравнения диффузия - дрейф для этого случая может быть найдено лишь численными методами. Это решение дает значение предельной частоты дрейфо- 2* 19 вого транзистора со как частоты, на которой модуль коэффициента передачи уменьшается в У2 раз по сравнению с НЧ значением. В дрейфовом транзисторе носи-  <7,7 £i,S 0,5 1,0 Рис. 1.8 тели претерпевают больший фазовый сдвиг и имеют меньшее время задержки, чем в бездрейфовом. Это отражается приближенными выражениями 1 + W 2Рп (1 + (rio) с + п' 1,21 (1.16) где з. = Ц77(2Ш'); =4/(Ч- l + e ); m=0.21 + +0,1tj - избыточный фазовый коэффициент; tj= = 1пЛб(0)/Л/б(Р')-коэффициент поля, определяемый отношением концентраций примесей вблизи базы и коллектора. При малом перепаде концентраций примесей в базе (JV(0)/JV(H7)<1,5) два последних равенства выражения (1.I6) некорректны. При N(<d)INв соответствии с (1-16) а (4=0)- * действительности это отношение равно единице. При малых перепадах концентраций значительно точнее оказывается эмпирическое выра 20 жение а Vn(W) (1.17) Использование для практических расчетов частотных зависимостей, полученных непосредственно решением уравнений переноса, неудобно. Эти уравнения содержат гиперболические функции от мнимого аргумента. Выражение (1.15) можно упростить, разложив schx и ограничившись первыми двумя членами разложения: Р*= l + 1.2j(o)/o)J-0,25(u)/o)J= (- В еще более приближенном виде Амплитудная характеристика, определяемая упрощенным выражением (1.19), близка к теоретической диффузионной кривой (1.11), однако фазочастотная характеристика проходит существенно ниже теоретической. Введение в (1.19) фазового множителя е позво- ляет получить удовлетворительное соответствие теории. Скорректировав зависимость (1.19): P*=p*.e- ° 7(14-jco/a.J, (1.20) будем ею пользоваться в дальнейшем. Таким образом, моделью базовой области является генератор с частотно-зависимым коэффициентом передачи §* (рис. 1.9,а). Заметим, что электрическим аналогом диффузионного переноса является распространение волны в линии с потерями, а приближенное выражение (1.19) является моделью простой /?С -цепи, для которой коэффициент передачи Рис. 1.9 где RC-l/m (иногда С отождествляют с диффузионной емкостью перехода). Тогда в схеме на рис. 1.9, б R = Таким образом, базовую область можно также аппроксимировать в первом приближении частотно-независимым генератором р*о, коэффициент передачи которого скорректирован в диапазоне частот пассивными элементами RC (рис. 1.9,6). Этой моделью пользоваться не будем, так как уточнение модели в соответствии с (1.20) вновь приводит к необходимости введения частотно-зависимого генератора. p*g--i / a. (Хотелось бы обратить внимание на то, что со в любом случае определяется выражением (1.13) или (1.16) и не может быть найдена никакой аппроксимацией с помощью электрических аналогов.) Коллектор. Следует различать запаздывание в собственно коллекторном переходе (обедненном слое перехода) и запаздывание в толще полупроводника, находящемся вне его. Обедненный слой коллекторного р - -перехода. Запаздывание тока, выходящего из обедненного слоя, / вых относительно тока, входящего в него, /sbx приводит к уменьшению модуля коэффициента передачи в обедненном слое iPsI и отставанию его фазы ф^. Для оценки этих явлений можно использовать анализ нитевидного транзистора, приведенный в [1.2]. На основании этого анализа можно показать, что в результате конечного времени пролета носителей коэффициент передачи коллекторного перехода составит sin- - = e (1.21) где Ws - толщина обедненного слоя коллектора; Vs - предельная скорость носителей, ограниченная рассеянием на примесях (5-10 см/с). Как видно, из-за конечного времени пролета запаздывание сигнала составит Wsl2vs, модуль коэффициента пе- редачи Ps будет уменьшаться с ростом sin- Критическая частота обедненного слоя коллектора может быть определена из условия Ps = l 2. Не-22 трудно убедиться, что такое уменьшение коэффициента передачи происходит на частоте (iis2,8lts=2,8vslWs. (1.22) При этом фазовый сдвиг Ц)=ш1в12=1,4 рад. Нетрудно показать, что аппроксимация обедненной области коллекторного перехода с помощью С-цепи позволяет представить приближенно Ps в виде, симметричном (1.20), 1.4ю 1,4<о/щ 1-Ь](о/со5 (1.23) где т =0,6. В практических расчетах обычно принимают Р.=1. Толщина обедненного слоя Ws может быть найдена в предположении, что он распространяется на область коллектора, а в области базы переход является резким. В этом случае (1.24) где Na. - концентрация акцепторов в коллекторе вблизи базы; Vk - напряжение на коллекторном переходе. Емкость коллекторного перехода можно определить с помощью выражения для емкости резкого перехода (1.4). Поскольку Ws известна, активная емкость коллекторного перехода Са=у4эЕотнео/8, (1.25) где As - площадь эмиттера. Заметим, что отношение VkIWs, пропорциональное У^&Ук и определяющее среднюю напряженность поля в коллекторном переходе, не должно превышать критического значения -10 В/см во избежание пробоя. Толща полупроводника коллектора. Область обедненного слоя не распространяется обычно до вывода коллектора, и между коллекторным переходом и выводом находится слой полупроводника с сопротивлением с= =р1с1Ак, где р - удельное сопротивление слоя; 4 -его протяженность в продольном направлении; -площадь коллектора. Поскольку ток в цепи сигнала не может воз- расти, пока не зарядится коллекторная емкость Са, в цепи сигнала происходит задержка. За время /с=1/сйс (где сйс=1 ?сСа - критическая частота цепи) происходит отставание сигнала на наличия цепи сСа коэффициент передачи D {евых 1 Рс ~ 7--------- 1 + j<o/?Ca - 1 +J (1.26) коллекторной 1 рад. Из-за (1.27) ю Рис. 1.10 где Са - активная емкость коллекторного перехода, т. е. емкость под эмиттером, поскольку мы пока не рассматриваем поперечной структуры прибора и связанной с ней пассивной емкости. Электрические модели двух областей коллекторного перехода представлены на рис. 1.10. Продольная структура в целом. После того как коэффициенты передачи всех областей транзистора определены через характеристические частоты этих областей coi, можно представить коэффициент передачи тока от эмиттера к коллектору, т. е. результирующий коэффициент передачи в виде произведения коэффициентов передачи отдельных областей (поскольку /эвых=/свх, /бвых=/8вх, 8вых=-свх) а,- е (1.28) где <Xi. = Y.P*.Ps.; = V. Полученное выражение характеризует коэффициент передачи тока в транзисторе без учета его поперечной структуры, т. е. в предположении, что его сопротивление базы /?б=0. Поэтому а, иногда называют внутренним коэффициентом передачи. Как видно, фазочастотные характеристики коэффициентов передач всех областей тран-24 зистора близки к линейным, если транзистор используют на частотах, намного меньших, чем характеристические частоты отдельных областей, и времена задержек этих областей в первом приближении не зависят от частоты. Это позволяет определить граничную частоту транзистора как частоту, на которой фазовый сдвиг выходного сигнала по отношению к входному равен 1 рад: 1/4 к, сог= где -Rfi,. (1.29) к = + + + с = эС,+ Таким образом, частота сог равна величине, обратной суммарной задержке сигнала. В линейном приближении, т. е. в пренебрежении квадратичными членами в знаменателе (1.28), l J= /./Vi+(-W- (1.30) На частоте ih-u/t модуль ai уменьшится в 1/2 раз-На СВЧ удобнее пользоваться не внутренним коэффициентом передачи щ, а имеющим более простой вид коэффициентом передачи теоретической модели СВЧ транзистора, обозначаемым далее через а: (1.31) где aio=YoP*oPso характеризует явления в базе и обедненном слое коллектора в отличие от отм НЧ и ВЧ транзисторов, который характеризует лишь пролетные явления в базе. Управляющим током в модели, описываемой выражением (1.31), является не инжектируемый ток h, а общий ток /э, зарядная емкость Cj соответственно введена в теоретическую модель (рис. 1.11,а). В (1.31) не отражено влияние постоянной времени коллекторной цепи на характеристики транзистора. Это влияние учтено соответствующими элементами в модели на рис. 1.11,6. Модуль коэффициента передачи обедненного слоя коллектора принимается Ps = l Электрическую модель продольной структуры транзистора, представленную на рис. 1.11,6, в дальнейшем 1 2 3 4 ... 6 |
|
© 2026 AutoElektrix.ru
Частичное копирование материалов разрешено при условии активной ссылки |